Іонна імплантація – це низькотемпературний процес, за допомогою якого компоненти одного елемента прискорюються в тверду поверхню пластини, тим самим змінюючи фізичні, хімічні чи електричні властивості. Даний спосіб використовується у виробництві напівпровідникових приладів та у обробці металів, а також у дослідженнях матеріалознавства. Компоненти можуть змінювати елементний склад пластини, якщо вони зупиняються і залишаються в ній. Іонна імплантація також викликає хімічні і фізичні зміни, коли атоми стикаються з метою при високій енергії. Кристалічна структура пластини може бути пошкоджена або навіть знищена енергетичними каскадами зіткнень, і частинки досить високої енергії (10 Мев) можуть викликати ядерну трансмутацию.
Загальний принцип встановлення іонної імплантації
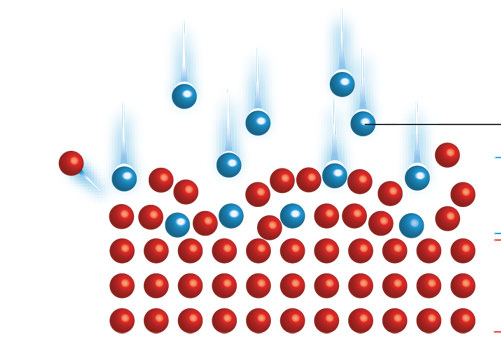
Обладнання зазвичай складається з джерела, де утворюються атоми бажаного елемента, прискорювача, де вони електростатично прискорюються до високої енергії, і камери-мішені, де вони стикаються з метою, яка є матеріалом. Таким чином, даний процес – це приватний випадок випромінювання частинок. Кожен іон зазвичай являє собою окремий атом або молекулу, і, таким чином, фактична кількість матеріалу, імплантованого в мішень, є інтегралом у часі іонного струму. Це число називається дозою. Струми, що подаються імплантатами, зазвичай малі (микроамперы), і, отже, кількість, яку можна імплантувати за розумний час, невелике. Тому іонна імплантація знаходить застосування в тих випадках, коли кількість необхідних хімічних змін невелика.
Типові енергії іонів знаходяться в діапазоні від 10 до 500 кев (від 1600 до 80000 аДж). Можна використовувати іонну імплантацію при низьких енергіях в діапазоні від 1 до 10 кев (від 160 до 1600 аДж), але при цьому проникнення становить усього кілька нанометрів або менше. Потужність нижче цього призводить до дуже незначного пошкодження цілі і потрапляє під позначення іонного пучкового осадження. І також можна використовувати більш високі енергії: поширені прискорювачі, здатні до 5 Мев (800 000 аДж). Тим не менш часто наноситься великий структурний збиток мети, і оскільки розподіл по глибині є широким (пік Брегга), чиста зміна складу в будь-якій точці мети буде невеликим.
Енергія іонів, а також різні види атомів і складу мішені визначають глибину проникнення часток в тверде тіло. Моноенергетичний іонний пучок зазвичай має широкий розподіл по глибині. Середня проникнення називається діапазоном. У типових умовах він буде між 10 нанометрами і 1 мікрометром. Таким чином, низкоэнергетическая іонна імплантація особливо корисна в тих випадках, коли бажано, щоб хімічне або структурна зміна було поблизу поверхні мішені. Частинки поступово втрачають свою енергію при проходженні через тверде тіло, як від випадкових зіткнень з атомами-мішенями (які викликають різкі перенесення енергії), так і від легкого гальмування від перекриття електронних орбіталей, що є безперервним процесом. Втрата енергії іонів в мішені називається зупинкою і може бути змодельована за допомогою методу іонної імплантації наближення бінарних зіткнень.
Прискорювальні системи зазвичай поділяються на середній струм, високий, велику енергію і дуже значну дозу.
Всі різновиди конструкцій пучків іонної імплантації містять певні загальні групи функціональних компонентів. Розглянемо приклади. Перші фізичні і фізико-хімічні основи іонної імплантації включають в себе пристрій, відоме як джерело для генерування частинок. Даний прилад тісно пов’язаний зі зміщеними електродами для вилучення атомів в лінію пучка і найчастіше з деякими засобами вибору для конкретних видів транспорту в головну секцію прискорювача. Обрання «маси» часто супроводжується проходженням виведеного іонного пучка через область магнітного поля з вихідним шляхом, обмеженим блокуючими отворами або щілинами», які допускають тільки іони з певним значенням добутку маси і швидкості. Якщо поверхня мішені більше діаметра іонного пучка і бажано рівномірніше розподілена імплантована доза по ній, то використовується певна комбінація сканування променя і руху пластини. Нарешті, мета з’єднується з деяким способом збору накопиченого заряду імплантованих іонів, так що доставляються доза може вимірюватися безперервним чином і процес зупиняється на бажаному рівні.
Застосування у виробництві напівпровідникових приладів
Легування бором, фосфором або миш’яком є поширеним застосуванням даного процесу. При іонній імплантації напівпровідників кожен атом допанта може створювати носій заряду після відпалу. Можна спорудити дірку для легуючої домішки р-типу і електрон n-типу. Це змінює провідність напівпровідника в його околиці. Техніка використовується, наприклад, для регулювання порогу MOSFET.
Іонна імплантація була розроблена як метод отримання pn-переходу фотоелектричних пристроїв в кінці 1970-х і початку 1980-х років поряд з використанням імпульсного електронного пучка для швидкого відпалу, хоча до цього часу вона не застосовувалася для комерційного виробництва.
Кремній на ізоляторі

Одним з відомих способів одержання даного матеріалу на підкладках діелектрика (SOI) із звичайних кремнієвих підкладок є процес SIMOX (поділ за допомогою імплантації кисню), в якому засипаний повітря з високою дозою перетворюється в оксид кремнію завдяки процесу високотемпературного відпалу.
Мезотаксия
Це термін для зростання кристаллографически збігається фази під поверхнею основного кристала. У цьому процесі іони імплантуються з досить високою енергією і дозою в матеріал для створення шару другої фази, а температура регулюється таким чином, щоб структура мішені не руйнувалася. Кристалічна орієнтація шару може бути спроектована так, щоб відповідати мети, навіть якщо точна постійна решітки може сильно відрізнятися. Наприклад, після імплантації іонів нікелю в кремнієву пластину можна вирощувати шар силіцидів, в якому орієнтація кристалів збігається зі значеннями кремнію.
Застосування в металевій обробці

Азот або інші іони можуть бути імплантовані в мішень з інструментальної сталі (наприклад, свердла). Структурна зміна провокує поверхневе стиснення в матеріалі, що запобігає поширенню тріщин і, таким чином, робить його більш стійким до руйнування.
Обробка поверхні

У деяких застосуваннях, наприклад для протезів, таких як штучні суглоби, бажано мати мету, дуже стійку і до хімічної корозії, і до зносу через тертя. Іонна імплантація використовується для конструювання поверхонь таких пристроїв для більш надійної роботи. Як і у випадку інструментальних сталей, модифікація мети, викликана іонною імплантацією, включає як поверхневе стиск, який запобігає розповсюдженню тріщин, так і легування, щоб зробити її більш хімічно стійкою до корозії.
Інші програми

Імплантація може бути використана для досягнення змішування іонних пучків, тобто змішування атомів різних елементів на межі розділу. Це може бути корисно для досягнення градуйованому поверхонь або посилення адгезії між шарами незмішувані матеріалів.
Формування наночастинок
Іонна імплантація може бути використана для індукції нанорозмірних матеріалів в оксидах, таких як сапфір і діоксид кремнію. Атоми можуть бути сформовані в результаті осадження або утворення змішаних речовин, які містять як іонно-імплантований елемент, так і підкладку.
Типові енергії іонного пучка, що використовуються для отримання наночастинок, знаходяться в діапазоні від 50 до 150 кев, а флюенс іонів — від 10-16 до 10-18 кв. див. Може бути сформована велика різноманітність матеріалів з розмірами від 1 нм до 20 нм і з композиціями, які можуть містити імплантовані частинки, комбінації, які складаються з катіона, пов’язаного з субстратом.
Речовини на основі діелектриків, таких як сапфір, які містять дисперсні наночастинки іонної імплантації металів, є перспективними матеріалами для оптоелектроніки та нелінійної оптики.
Проблеми
Кожен окремий іон виробляє багато точкових дефектів в цільовому кристалі при ударі або впровадженні. Вакансії – це точки решітки, не зайняті атомом: в цьому випадку іон стикається з атомом-мішенню, що призводить до передачі значної кількості енергії йому, так що він залишає свою ділянку. Цей цільовий об’єкт сам стає снарядом у твердому тілі і може викликати послідовні зіткнення. Міжвузля виникають, коли такі частинки зупиняються в твердому тілі, але не знаходять вільного місця в решітці для проживання. Ці точкові дефекти при іонній імплантації можуть мігрувати і кластеризоваться один з одним, що призводить до утворення дислокаційних петель та інших проблем.
Аморфізація
Кількість кристалографічного пошкодження може бути достатнім для повного переходу поверхні мішені, тобто воно має стати аморфним твердим речовиною. У деяких випадках повна аморфізація мішені краще, ніж кристал з високим ступенем дефектності: така плівка може повторно зростати при більш низькій температурі, ніж потрібно для відпалу сильно пошкодженого кристала. Аморфізація підкладки може відбуватися в результаті зміни променя. Наприклад, при імплантації іонів ітрію в сапфір при енергії пучка 150 кев до флюенса 5*10-16 Y+/кв. см утворюється склоподібний шар товщиною приблизно 110 нм, виміряний з зовнішньої поверхні.
Розпилення
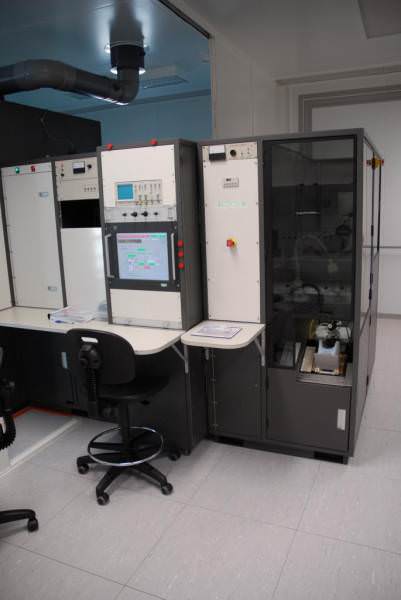
Деякі з подій зіткнення призводять до того, що атоми викидаються з поверхні, і, таким чином, іонна імплантація буде повільно витравлювати поверхню. Ефект помітний тільки для дуже великих доз.
Іонний канал
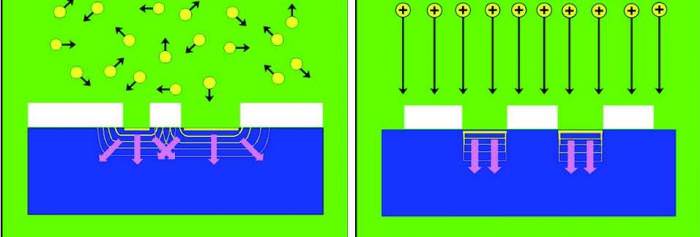
Якщо до мішені прикладена кристалографічна структура, особливо в напівпровідникових підкладках, де вона більш відкрита, то конкретні напрями зупиняють набагато менше, ніж інші. Результатом є те, що радіус дії іона може бути набагато більше, якщо він рухається точно вздовж певного прямування, наприклад в кремнії та інших кубічних матеріалах алмазу. Цей ефект називається іонним каналированием, і, як і всі подібні ефекти, високою мірою нелінійні, з невеликими відхиленнями від ідеальної орієнтації, що призводять до значних відмінностей у глибині імплантації. З цієї причини велика частина виконується на кілька градусів поза осі, де крихітні помилки вирівнювання будуть мати більш передбачувані ефекти.












